
Welcome to Shenzhen Sing Fung Intelligent Manufacturing Co., Ltd.
E-mail:shaobo@sfi-crf.com
Plasma plasma processing system manufacturers indium gallium arsenic etching
- Categories:Technical Support
- Author:plasma cleaning machine-surface treatment equipment-CRF plasma machine-Sing Fung Intelligent Manufacturing
- Origin:
- Time of issue:2021-03-19
- Views:
(Summary description)The main use of indium gallium arsenic is as a channel material, and it is considered as the future channel material of nanometer NMOS. On the one hand, indium gallium and arsenic will form a layer or multiple quantum well transmission in the channel, and its mobility can reach the level of single crystal, and the main restriction will appear at the contact interface. The advantage of this for etching is a single purpose, which is to define the pattern of the channeling material. In the early stage, CCl2F2 gas was used for etching. However, due to the reasons of selective ratio and plasma damage to the underlying film, two combination gas plasma etching schemes, CHF3+BCl3 and CF4+BCl3, were developed. In effect, both schemes can achieve a faster etching rate and a higher selectivity ratio to Inalas, and are easier to achieve at low voltage and high RF power. The difference in etch rate between two similar materials is due to the difference in volatilization of reaction products. Both CaCl3 and AsCl3 are relatively volatile, while AlCl3 is more difficult to volatilize, which will affect further etching. The amount of fluorine will affect the etching rate of Inaias. The increase of fluorine gas flow rate will significantly change the selection ratio of indium aluminum arsenic and indium gallium arsenic. Gas combinations using CHF3 and BCL3 or CF4 and BCL3 options can more than double the ratio. The influence of the pressure and radio frequency power of the two gas combinations on the etching rate: the higher the pressure, the lower the etching rate of the two combinations, which is consistent with our general etching law, because the increase of pressure will increase the probability of plasma collision and annihilation, reduce the energy of plasma, and lead to the decrease of the etching rate. In general, the higher the RF power, the faster the etch rate, because the dissociation rate of the plasma will be higher. These methods of etching are more common, more thoroughly studied and reported a lot. In contrast, the etching details of indium gallium and arsenic in the fabrication of the fet have not been disclosed, despite reports of indium gallium and arsenic. Judging from the gas used, it should be a combination of chemical reaction and high-speed bombardment. BCl3 is easy to react with various elements in indium gallium and arsenic, while Ar may be the source of bombardment. From the defined figure, there is an inclined side wall topography, but the overall height is high. The newly developed neutral particle etching has also been applied to the etching of indium gallium and arsenic. The research group in Japan has done more research on the neutral particle etching of group 35 compounds. Not only did they use this very advanced etching technique, but they also used organic materials as the etching mask. The original organic mask material is soft and easy to deform, collapse and produce defects under the bombardment of plasma, which leads to the deviation of graphic definition. This is also the reason why the processing of integrated circuits gradually changes from soft and single mask material to hard and multi-layer mask material. But paired with neutral particle etching, softer organic masks are available again. Because the neutral particles mainly rely on dry chemical etching, the electron temperature is very low, which can effectively protect the mask material. After indium gallium arsenic and gallium arsenic were repeatedly subjected to molecular beam epitaxy to form a multilayer structure, a polyethylene glycol containing an iron compound (an iron oxide containing water) was coated on the surface of the multilayer structure. Ferric compounds exist as the "nucleus" of organic materials, which can effectively control the distance between different nuclei. After completion, hydrogen plasma is used to remove the outer protective shell of the nucleus and then the oxygen in the oxide is removed to form isolated iron nanoparticles, which are distributed evenly and equidistant on the surface as a mask for etching. In order to prevent the secondary oxidation before etching, the hydrogen plasma can be processed before etching. The pattern is defined with chlorine neutral particles to complete the deep hole etching. The method can also be used for indium gallium arsenic and gallium arsenic compound semiconductors to form holes or grooves with high aspect ratio.Because the temperature can directly affect the rate of chemical reaction, this method can be used to control the etching rate and morphology in etching. There are problems in both low temperature and high temperature. It is difficult to obtain enough nanostructures at low temperature, and the morphology of the high surface will deteriorate seriously. Only at 50℃ can the deficiencies of the two aspects be balanced. The bias is also critical to define the morphology of th
Plasma plasma processing system manufacturers indium gallium arsenic etching
(Summary description)The main use of indium gallium arsenic is as a channel material, and it is considered as the future channel material of nanometer NMOS. On the one hand, indium gallium and arsenic will form a layer or multiple quantum well transmission in the channel, and its mobility can reach the level of single crystal, and the main restriction will appear at the contact interface. The advantage of this for etching is a single purpose, which is to define the pattern of the channeling material. In the early stage, CCl2F2 gas was used for etching. However, due to the reasons of selective ratio and plasma damage to the underlying film, two combination gas plasma etching schemes, CHF3+BCl3 and CF4+BCl3, were developed. In effect, both schemes can achieve a faster etching rate and a higher selectivity ratio to Inalas, and are easier to achieve at low voltage and high RF power. The difference in etch rate between two similar materials is due to the difference in volatilization of reaction products. Both CaCl3 and AsCl3 are relatively volatile, while AlCl3 is more difficult to volatilize, which will affect further etching.
The amount of fluorine will affect the etching rate of Inaias. The increase of fluorine gas flow rate will significantly change the selection ratio of indium aluminum arsenic and indium gallium arsenic. Gas combinations using CHF3 and BCL3 or CF4 and BCL3 options can more than double the ratio. The influence of the pressure and radio frequency power of the two gas combinations on the etching rate: the higher the pressure, the lower the etching rate of the two combinations, which is consistent with our general etching law, because the increase of pressure will increase the probability of plasma collision and annihilation, reduce the energy of plasma, and lead to the decrease of the etching rate. In general, the higher the RF power, the faster the etch rate, because the dissociation rate of the plasma will be higher.
These methods of etching are more common, more thoroughly studied and reported a lot. In contrast, the etching details of indium gallium and arsenic in the fabrication of the fet have not been disclosed, despite reports of indium gallium and arsenic. Judging from the gas used, it should be a combination of chemical reaction and high-speed bombardment. BCl3 is easy to react with various elements in indium gallium and arsenic, while Ar may be the source of bombardment. From the defined figure, there is an inclined side wall topography, but the overall height is high.
The newly developed neutral particle etching has also been applied to the etching of indium gallium and arsenic. The research group in Japan has done more research on the neutral particle etching of group 35 compounds. Not only did they use this very advanced etching technique, but they also used organic materials as the etching mask. The original organic mask material is soft and easy to deform, collapse and produce defects under the bombardment of plasma, which leads to the deviation of graphic definition. This is also the reason why the processing of integrated circuits gradually changes from soft and single mask material to hard and multi-layer mask material. But paired with neutral particle etching, softer organic masks are available again. Because the neutral particles mainly rely on dry chemical etching, the electron temperature is very low, which can effectively protect the mask material. After indium gallium arsenic and gallium arsenic were repeatedly subjected to molecular beam epitaxy to form a multilayer structure, a polyethylene glycol containing an iron compound (an iron oxide containing water) was coated on the surface of the multilayer structure. Ferric compounds exist as the "nucleus" of organic materials, which can effectively control the distance between different nuclei.
After completion, hydrogen plasma is used to remove the outer protective shell of the nucleus and then the oxygen in the oxide is removed to form isolated iron nanoparticles, which are distributed evenly and equidistant on the surface as a mask for etching. In order to prevent the secondary oxidation before etching, the hydrogen plasma can be processed before etching. The pattern is defined with chlorine neutral particles to complete the deep hole etching. The method can also be used for indium gallium arsenic and gallium arsenic compound semiconductors to form holes or grooves with high aspect ratio.Because the temperature can directly affect the rate of chemical reaction, this method can be used to control the etching rate and morphology in etching. There are problems in both low temperature and high temperature. It is difficult to obtain enough nanostructures at low temperature, and the morphology of the high surface will deteriorate seriously. Only at 50℃ can the deficiencies of the two aspects be balanced. The bias is also critical to define the morphology of th
- Categories:Technical Support
- Author:plasma cleaning machine-surface treatment equipment-CRF plasma machine-Sing Fung Intelligent Manufacturing
- Origin:
- Time of issue:2021-03-19 09:32
- Views:
Plasma plasma processing system manufacturers indium gallium arsenic etching:
The main use of indium gallium arsenic is as a channel material, and it is considered as the future channel material of nanometer NMOS. On the one hand, indium gallium and arsenic will form a layer or multiple quantum well transmission in the channel, and its mobility can reach the level of single crystal, and the main restriction will appear at the contact interface. The advantage of this for etching is a single purpose, which is to define the pattern of the channeling material. In the early stage, CCl2F2 gas was used for etching. However, due to the reasons of selective ratio and plasma damage to the underlying film, two combination gas plasma etching schemes, CHF3+BCl3 and CF4+BCl3, were developed. In effect, both schemes can achieve a faster etching rate and a higher selectivity ratio to Inalas, and are easier to achieve at low voltage and high RF power. The difference in etch rate between two similar materials is due to the difference in volatilization of reaction products. Both CaCl3 and AsCl3 are relatively volatile, while AlCl3 is more difficult to volatilize, which will affect further etching.
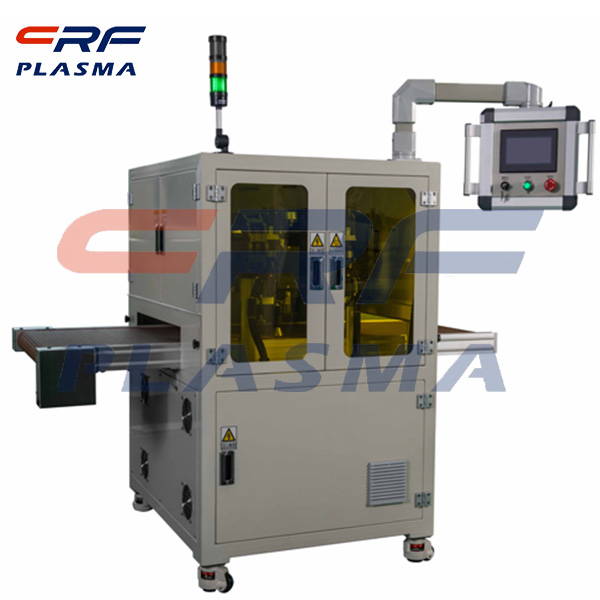
The amount of fluorine will affect the etching rate of Inaias. The increase of fluorine gas flow rate will significantly change the selection ratio of indium aluminum arsenic and indium gallium arsenic. Gas combinations using CHF3 and BCL3 or CF4 and BCL3 options can more than double the ratio. The influence of the pressure and radio frequency power of the two gas combinations on the etching rate: the higher the pressure, the lower the etching rate of the two combinations, which is consistent with our general etching law, because the increase of pressure will increase the probability of plasma collision and annihilation, reduce the energy of plasma, and lead to the decrease of the etching rate. In general, the higher the RF power, the faster the etch rate, because the dissociation rate of the plasma will be higher.
These methods of etching are more common, more thoroughly studied and reported a lot. In contrast, the etching details of indium gallium and arsenic in the fabrication of the fet have not been disclosed, despite reports of indium gallium and arsenic. Judging from the gas used, it should be a combination of chemical reaction and high-speed bombardment. BCl3 is easy to react with various elements in indium gallium and arsenic, while Ar may be the source of bombardment. From the defined figure, there is an inclined side wall topography, but the overall height is high.
The newly developed neutral particle etching has also been applied to the etching of indium gallium and arsenic. The research group in Japan has done more research on the neutral particle etching of group 35 compounds. Not only did they use this very advanced etching technique, but they also used organic materials as the etching mask. The original organic mask material is soft and easy to deform, collapse and produce defects under the bombardment of plasma, which leads to the deviation of graphic definition. This is also the reason why the processing of integrated circuits gradually changes from soft and single mask material to hard and multi-layer mask material. But paired with neutral particle etching, softer organic masks are available again. Because the neutral particles mainly rely on dry chemical etching, the electron temperature is very low, which can effectively protect the mask material. After indium gallium arsenic and gallium arsenic were repeatedly subjected to molecular beam epitaxy to form a multilayer structure, a polyethylene glycol containing an iron compound (an iron oxide containing water) was coated on the surface of the multilayer structure. Ferric compounds exist as the "nucleus" of organic materials, which can effectively control the distance between different nuclei.
After completion, hydrogen plasma is used to remove the outer protective shell of the nucleus and then the oxygen in the oxide is removed to form isolated iron nanoparticles, which are distributed evenly and equidistant on the surface as a mask for etching. In order to prevent the secondary oxidation before etching, the hydrogen plasma can be processed before etching. The pattern is defined with chlorine neutral particles to complete the deep hole etching. The method can also be used for indium gallium arsenic and gallium arsenic compound semiconductors to form holes or grooves with high aspect ratio.Because the temperature can directly affect the rate of chemical reaction, this method can be used to control the etching rate and morphology in etching. There are problems in both low temperature and high temperature. It is difficult to obtain enough nanostructures at low temperature, and the morphology of the high surface will deteriorate seriously. Only at 50℃ can the deficiencies of the two aspects be balanced. The bias is also critical to define the morphology of the graph, which can effectively balance the etching rate between different materials. This is also very important for the definition of multi-layer graphics with high aspect ratio, otherwise multiple curvatures will be formed to shape or even deform. Low bias does not allow the nanostructure to be of sufficient height, that is, there will be a large slanting side wall or even etching termination at the bottom of the pattern, but high bias will consume the iron-containing "core" that serves as the mask, making it equally difficult to obtain the desired pattern. The damage of gallium and arsenic semiconductor etched by neutral particle etching method is compared. The more the light intensity, the more serious the damage. In narrow gap in the definition, the damage to the neutral particles force is less than 1/10 of the plasma in a row, although the actual experimental results zero injury is not as theory, but this kind of low damage force definition of graphics has play a crucial role, especially in the new semiconductor etching process, generally have high activity, and the characteristics of the protection film. So the study of neutral particle etching is very necessary.
Scan the QR code to read on your phone

TEL:0755-3367 3020 / 0755-3367 3019

E-mail:sales-sfi@sfi-crf.com

ADD:Mabao Industrial Zone, Huangpu, Baoan District, Shenzhen